- 8 (812) 612-97-27
- СПБ, Курчатова дом 1А помещение 1Н
- order@das-elektro.de
Сильноточные силовые SiC-модули, выпускаемые компанией Mitsubishi Electric для разных классов напряжения, широко известны в отрасли. В настоящее время производятся 1200-и 1700-В силовые SiC-модули второго поколения, характеристики которых стали лучше, чем у изделий первого поколения. Кроме того, линейка новых модулей стала шире. В кристаллы MOSFET силовых SiC-модулей с номинальным напряжением 3300 и 6500 В компания Mitsubishi Electric встраивает диоды Шоттки. В статье рассматриваются результаты самых последних исследований этой передовой технологии.
Введение
Применение карбида кремния (sic) стало еще одним большим шагом в современной силовой электронике. Силовые устройства на основе sic обладают большими возможностями и более высоким КПД по сравнению с традиционными кремниевыми материалами. Компания Mitsubishi Electric приступила к разработке силовых полупроводников на основе карбида кремния еще в начале 1990-х гг. За последние 10 лет ей удалось коммерциализировать много sic-устройств с разными значениями номинального напряжения и тока. Особое внимание при этом было уделано большим sic-кристаллам и сильноточным sic-модулям. В некоторых приложениях, например в грузоподъемном оборудовании, источниках бесперебойного питания, фотоэлектрических системах и в железнодорожном транспорте использование высокомощных sic-модулей обеспечивает очень привлекательные характеристики, в т.ч. плотность мощности.
Рисунок 1
Рисунок 2

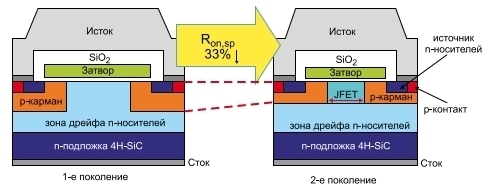
SiC-модуль 2-го поколения с rtC-защитой от короткого замыкания, полностью базирующийся на SiC-устройствах
Поперечное сечение кристаллов SiC MOSFet 1-го и 2-го поколений
В статье рассматриваются результаты самых последних научноисследовательских работ компании Mitsubishi в области карбидокремниевых силовых модулей. В частности, мы представим 1200- и 1700-В модули 2-го поколения, инновационные решения и более совершенные характеристики по сравнению с характеристиками модулей предыдущего поколения.
Одним из препятствий на пути повышения номинального напряжения карбидокремниевых MosFET является ухудшение (деградация) характеристик внутреннего диода. Чтобы обойти это препятствие, применяется диод Шоттки, установленный антипараллельно sic MosFET. Компания Mitsubishi интегрирует этот диод в кристалл MosFET, благодаря чему существенно повышается плотность мощности высоковольтных sic-устройств. Подробности такого решения рассматриваются в заключительном разделе этой статьи для 3300- и 6500-В устройств.
6-Дюймовые SIC-Модули 2-го поколения
Давайте рассмотрим 4H-sic MosFET 2-го поколения от компании Mitsubishi с номинальными напряжениями на 1200 и 1700 В (см. в [2] характеристики 600-В sic MosFET). Как видно из рисунка 1, шаг между ячейками 1200-В ключей sic MosFET 2-го поколения с оптимизированным p-карманом, выпущенных на недавно разработанной линии по производству 6-дюймовых sic-пластин, стал меньше. Оптимизирован был и профиль легирования канала (см. рис. 2) [3]. В результате повысилась надежность оксидного слоя затвора, и уменьшились потери на проводимость. На рисунке 3 представлена зависимость удельного сопротивления открытого канала Ron, sP при комнатной температуре 1200-В кристаллов MosFET 1-го и 2-го поколений с номинальной плотностью тока 100 a/см2. Видно, что этот показатель уменьшился на 33% с 4,5 до 3,0 мОм∙см2 благодаря оптимизированной структуре ячеек.
При сокращении шага между ячейками сужается область JFET. Если ее ширина становится слишком малой, увеличивается сопротивление канала в открытом состоянии. Однако компания Mitsubishi решила эту проблему путем легирования области JFET (см. рис. 4). Благодаря оптимизированному легированию JFET планарные ключи MosFET могут составить конкуренцию современным trench-структурам, что видно из рисунка 5. В то же время планарная структура менее сложна по сравнению с затворной trench-структурой.
Рисунок 3
Рисунок 4
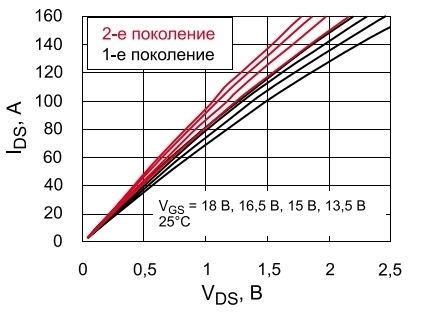
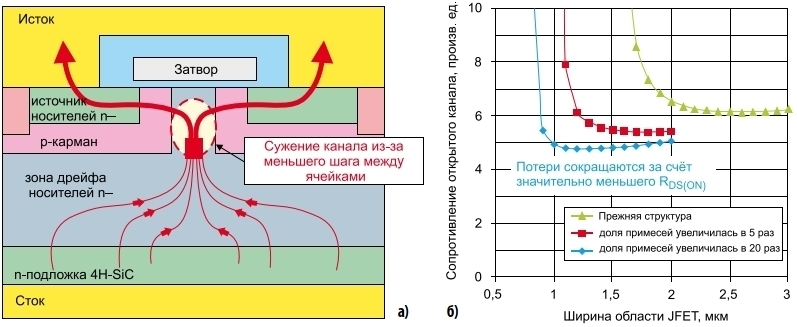
типовые выходные характеристики 1200-В SiC MOSFet 1-го и 2-го поколений [3]
а) поперечное сечение SiC MOSFet; б) влияние легированной области JFet на сопротивление канала в открытом состоянии
Рисунок 5
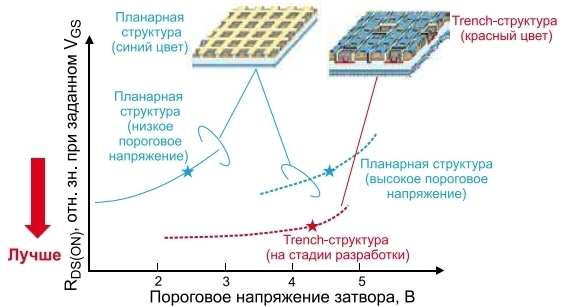
Сравнение значений сопротивления rDS(ON) 1200-В ключей SiC MOSFet, имеющих планарную и trench-структуру (т = 25°С)
Коммутационная характеристика sic MosFET 2-го поколения тоже улучшилась. Емкость Миллера стала меньше, благодаря чему выросла частота коммутации. Как видно из рисунка 6, потери на включение и выключение уменьшились на 23 и 37%, соответственно, по сравнению с устройствами предыдущего поколения.
Уменьшился шаг между ячейками и у 1700-В ключей sic MosFET. Кроме того, у них так же оптимизирован профиль легирования. В [4] демонстрируется эффективность этих сильноточных кристаллов в полумостовом модуле на 300 А. Величина VDs(on) составляет 2,75 В при токе-стока 300a и температуре перехода 150°c. Значения Eon и EoFF при 300a и 150°c равны 12,0 и 3,0 мДж, соответственно (при RG = 1,6 мОм). Эти характеристики проводимости и коммутации – среди самых лучших из известных.
Как правило, величину RDs(on) нельзя существенно уменьшить во избежание короткого замыкания (КЗ). Вообще говоря, обеспечение защиты sic-устройств от КЗ является достаточно трудной задачей. С учетом этого обстоятельства компания Mitsubishi Electric разработала еще для sic-устройств 1-го поколения метод управления в реальном времени (RTc) [5], который обеспечивает собственную быструю защиту от КЗ. На рисунках 7–8 показана принципиальная схема RTc и форма сигналов при коротком замыкании. Как только эта схема обнаруживает КЗ, она автоматически уменьшает напряжение затвора, чтобы ограничить величину тока короткого замыкания. В результате уменьшается энергия, рассеиваемая в это время в sic MosFET. Такая защита позволяет выбирать драйвер затвора и его характеристики, не предусматривая меры по быстрой защите от КЗ. Управление в реальном времени обеспечивает эффективную защиту от КЗ, что доказала эксплуатация sic-модулей 1-го поколения. Этой же схемой оснащена вся линейка устройств 2-го поколения компании Mitsubishi Electric с номинальным током в диапазоне 300–1200 А (см. табл.).
Рисунок 6
Рисунок 7


Коммутационные сигналы 1200-В ключей SiC MOSFet 1-го и 2-го поколений: а) включение; б) выключение [3]
Схема управления в реальном времени для защиты от короткого замыкания
Таблица

Линейка SiC MOSFet 2-го поколения * 2-в-1: полумостовой модуль, ** 4-в-1: полномостовой модуль
SIC-Модули для высоковольтных приложений
Биполярная деградация (BPD) – хорошо известный и описанный механизм ухудшения характеристик полупроводниковых sic-материалов (см. рис. 9). Причина деградации заключается в том, что при протекании двуполярного тока через внутренний диод sic MosFET возникает сдвиг sic-решетки [6, 7].
Для предотвращения этого нежелательного эффекта компания Mitsubishi установила sic-диод Шоттки параллельно внутреннему диоду MosFET.
Если падение напряжения на диоде Шоттки достаточно мало, через него протекает избыточный ток, что предотвращает протекание двуполярного тока через внутренний диод. Данный метод доказал свою эффективность за четыре года эксплуатации в полевых условиях 3300-В устройств, полностью выполненных на карбиде кремния.
Площадь области кристалла диода Шоттки, используемого для предотвращения биполярного тока, зависит от напряжения. Если номинальное напряжение составляет 3300 В, она в 1,3 раза превышает площадь кристалла MosFET, а у 6500-В устройства – в три раза. Поскольку в таких случаях ухудшается эффективность использования монтажной площади кристаллов в силовых модулях, компания Mitsubishi ищет более совершенные методы для высоковольтных устройств.
Использование диода Шоттки в кристалле MosFET – многообещающая идея, реализация которой была уже продемонстрирована на модели 6500-В sic MosFET [8, 9] (см. рис. 10).
Как видно из рисунка 11, площадь нового MosFET со встроенным диодом Шоттки стала меньше, благодаря чему возросла плотность мощности силового модуля.
Более того, благодаря встроенному диоду Шоттки обеспечиваются превосходные коммутационные характеристики 3300-В устройства [10]. На рисунке 12 показаны коммутационные сигналы ключей MosFET со встроенным диодом Шоттки, с внешним диодом Шоттки и без этого диода. Из графика видно, что у MosFET со встроенным диодом Шоттки – минимальные коммутационные потери, т. к. суммарный заряд QСУМ меньше, чем у всех устройств. В результате потери при замыкании ключа уменьшаются на 20% по сравнению с ключом с внешним диодом Шоттки. Более того, в отличие от MosFET без диода Шоттки, у ключа со встроенным диодом отсутствует биполярная деградация, и обеспечивается превосходная плотность мощности.
Рисунок 8
Рисунок 9
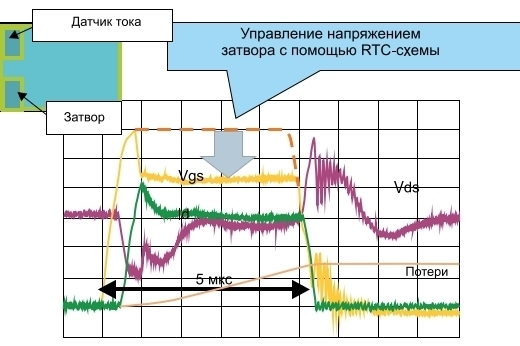
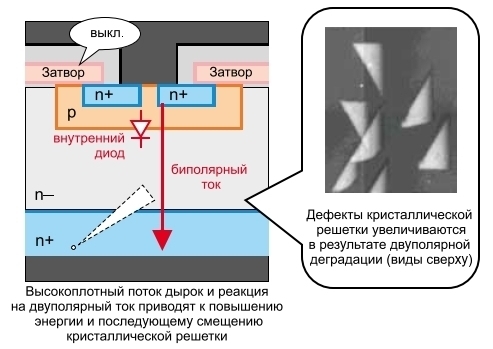
Управление в реальном времени для защиты от КЗ
Схематичное изображение поперечного сечения MOSFet с диодом Шоттки и фото дефектов кристаллической структуры из-за двуполярной деградации
Рисунок 10
Рисунок 11

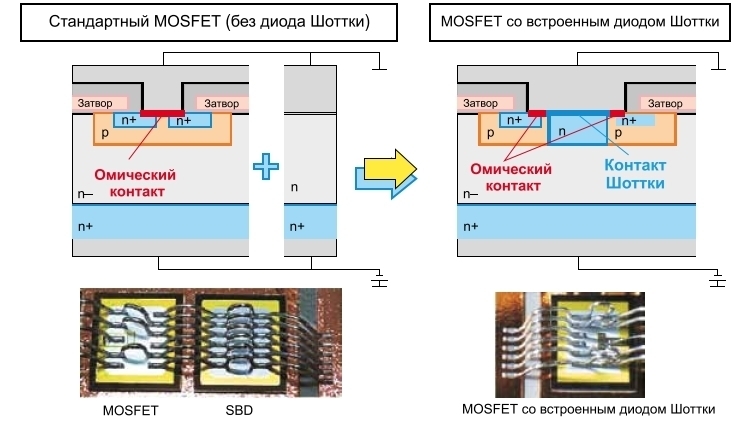
6500-В модуль в корпусе HV100, выполненный полностью на карбидокремниевых компонентах
Сравнение стандартного MOSFet с MOSFet со встроенным диодом Шоттки
Рисунок 12
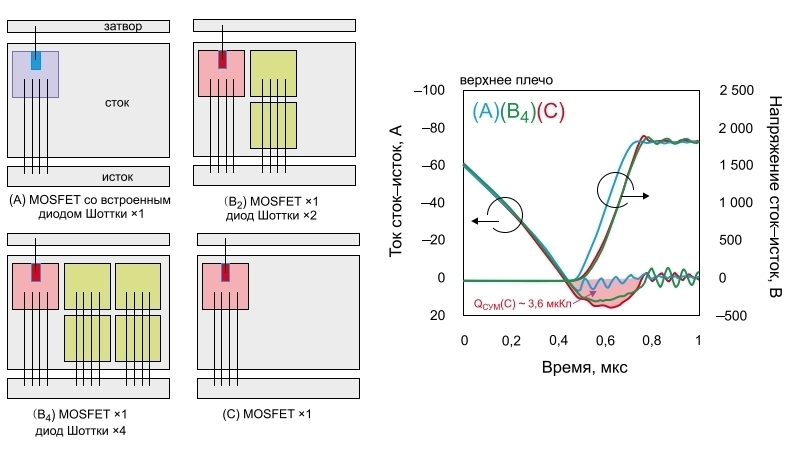
топология кристалла, токи и напряжения MOSFet: (A) со встроенным диодом Шоттки; (B4) с внешними диодами Шоттки; (C) без диода Шоттки [10]
Выводы
Преобразователи, в которых применяются карбидокремниевые силовые модули, – следующий большой шаг в современной силовой электронике. У этих модулей – наилучшие в своем классе значения плотности мощности и КПД. Компания Mitsubishi Electric предлагает силовые sic-модули с высокими номинальными токами во всех классах напряжения, которые требуются высокомощным преобразователям. В настоящее время компания выпускает 1200- и 1700-В sic-модули 2-го поколения. Эффективность этих устройств увеличилась, а технология RTc защищает их от короткого замыкания. Кристаллы MosFET с интегрированными диодами Шоттки позволяют реализовать силовые модули с высокой плотностью мощности для классов напряжения 3300 и 6500 В.
Компания Mitsubishi Electric, приступившая к проектированию карбидокремниевых устройств в 1990-х гг., в настоящее время располагает широкой линейкой sic-устройств в диапазоне 1200–3300 В. Модули с более высоким номинальным напряжением находятся на стадии разработки.
Корзина пуста
0
шт.
/
$0
Оформить
Очистить
